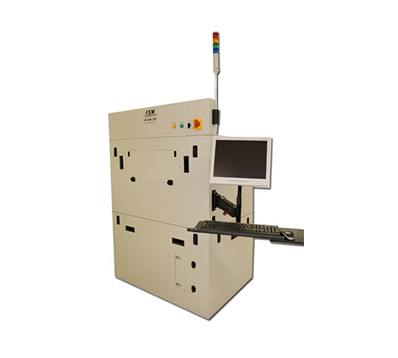
更新時間:2023-03-28
產品品牌:Frontier Semiconductor
產品型號:FSM 413 EC
非接觸式厚度測量,可以測量背麵研磨減薄和刻蝕後的薄晶圓,也可測量粘附在藍膜或者其他載體上的有圖形或凸起的晶圓,可應用於堆疊芯片和微機電係統。
優勢:
FSM413回波探頭傳感器使用紅外(IR)幹涉測量技術,可以直接和測量從厚到薄的晶圓襯底厚度變化和總體厚度變化。配置單探頭係統,可以測量一些對紅外線透明的材料,例如Si, GaAs, InP, SiC, 玻璃,石英和一些聚合物,還可以測量常規有圖形、有膠帶、凸起或者鍵合在載體上晶圓的襯底厚度。配置雙探頭係統時,還提供晶圓整體厚度測量(包括襯底厚度和在光不能穿透的情況下的圖形高度厚度)。選配功能可以測量溝槽深度和通孔深度(包括微機電中的高深寬比的溝槽和通孔)。另外微機電應用中薄膜厚度測量和凸塊高度測量也可以選配。
基於FSM Echoprobe紅外線幹涉測量技術,提供非接觸式芯片厚度和深度測量方法。
Echoprobe技術利用紅外光束探測晶圓。
Echoprobe可用於測量多晶矽、藍寶石、其它複合物半導體,例如GaAs, InP, GaP, GaN 等。
對晶圓圖形襯底切割麵進行直接測量。
行業應用:
主要應用在研磨芯片厚度控製、芯片後段封裝、TSV(矽通孔技術)、(MEMS)微機電係統、 側壁角度測量等。
針對LED行業, 可用作檢測藍寶石或碳化矽片厚度及TTV
其它應用:
·溝槽深度測量
·表麵粗糙度測量
·薄膜厚度測量
·環氧厚度測量
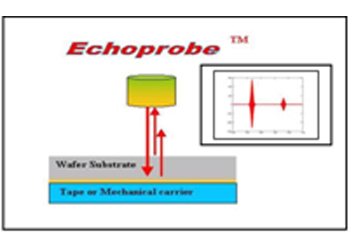
Echoprobe™ 回波探頭技術可提供對薄晶圓(<100um)的襯底厚度或粘結結構上的薄襯底進行直接和測量。
電話:86-021-37018108
傳真:86-021-57656381
郵箱:info@boyuesh.com
地址:上海市鬆江區莘磚公路518號鬆江高科技園區28幢301室