AFM電磁學工作模式及對應探針型號

PART.1
Conductive AFM 導電原子力顯微鏡
Conductive AFM (cAFM) — 導電原子力顯微鏡(CAFM)是一種源自接觸AFM的二次成像模式,它表征了中到低導電和半導體材料的導電率變化。CAFM的電流範圍為pA至μA。
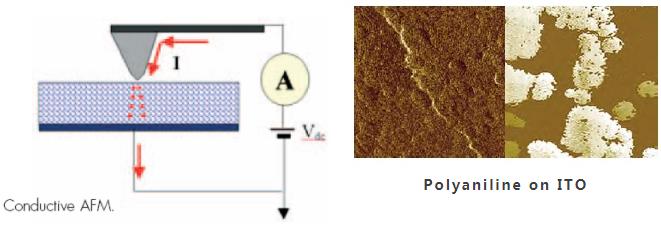
PART.2
Tunneling AFM 峰值力隧穿原子力顯微鏡
Tunneling AFM (TUNA) — 峰值力隧穿原子力顯微鏡(TUNA)的工作原理與導電AFM相似,但具有更高的靈敏度。TUNA表征了通過薄膜厚度的超低電流(80fA和120pA之間)。TUNA模式可以在成像或光譜模式下運行。
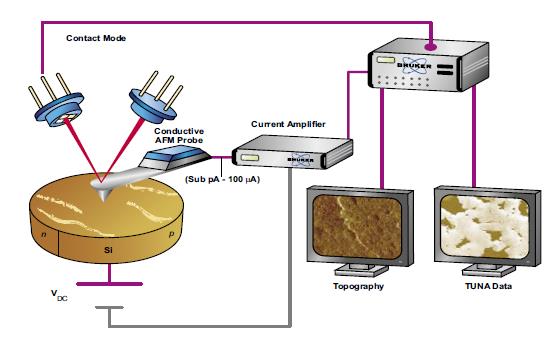
PART.3
Scanning Capacitance Microscopy 掃描電容顯微鏡
Scanning Capacitance Microscopy (SCM) — 掃描電容顯微鏡(SCM)繪製了樣品表麵(通常是摻雜半導體)上大多數載流子濃度(電子或空穴)的變化。SCM向樣本施加高頻(90 kHz)AC偏壓,並使用高頻(1 GHz)檢測器測量掃描樣本表麵時的局部樣本電容變化。這些電容變化是半導體中多數載流子濃度的函數;因此,相對載流子濃度可以映射在1016–1021 cm-3的範圍內。
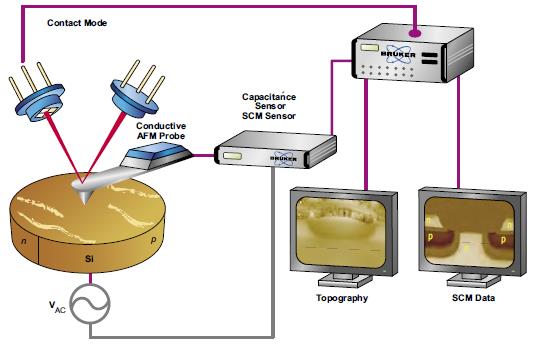
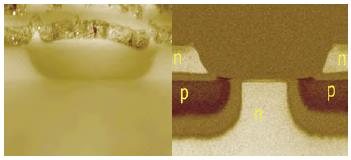
Laser Diode Cross Section
PART.4
Piezo Response Microscopy 壓電力響應顯微鏡
Piezo Response Microscopy (PFM) — 壓電力響應顯微鏡(PFM)是一種基於接觸模式的技術,可繪製樣品上的反向壓電效應。對樣品進行電刺激,並使用鎖定技術監測樣品的地形響應。振幅和相位信息揭示了關於樣品上極化的強度和方向的信息。
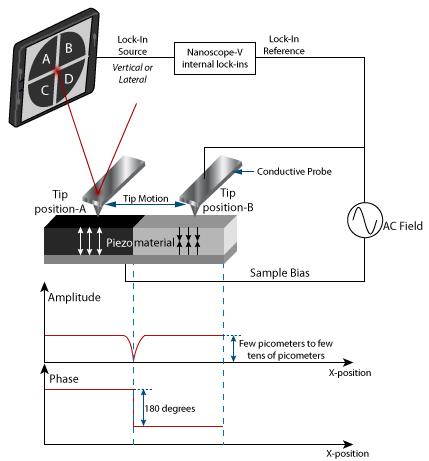

PPLN PFM Data
PART.5
Electric Force Microscopy 靜電力顯微鏡
Electric Force Microscopy (EFM) — 靜電力顯微鏡(EFM)通過導電探針測量樣品表麵上方的電場梯度分布。表征樣品表麵的靜電勢能,電荷分布及電荷運輸等。

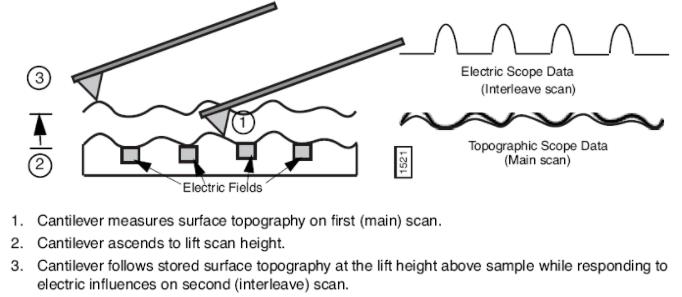
Carbon black particles, 3 mm scan size

常用探針選型: