
台階儀(探針式輪廓儀)通過記錄探針在物體表麵的垂直位移,從而達到測量物體表麵台階高度、粗糙度等物理參數的目的。主要用於薄膜材料厚度(2D)測量和表麵形貌測量(3D)。台階儀可獲得定量的台階高度、線粗糙度、薄膜曲率半徑,測量薄膜應力等。Bruker Dektak XT台階儀由於其操作簡單、分辨率高及重複性良好等優點,被廣泛用於半導體、微電子、太陽能、LED、觸摸屏、醫療等領域。
Bruker Dektak XT台階儀有以下特點:
高度方向采用的LVDT線性位移傳感器,該傳感器因其結構為無接觸式,使其具有無摩擦、無磨損等特點。
台階高度重現性小於4Å。
垂直分辨率高達1 Å。
標配探針更換工具,保證探針更換快捷。
標配薄膜應力測試功能。
精簡的Vision64 軟件係統,結合智能結構, 具備可視化工作流程及各種自助設定功能,以滿足用戶快速進行數據收集和分析。
近年來,為了打破國外對我國半導體芯片技術封鎖,解決“卡脖子”問題,國家加大對半導體芯片行業的投入。在政府的鼓勵及扶持下,各地半導體企業數量也來越多,規模及產能也越來越大。
晶圓在生產製造的過程中,會對晶圓進行鍍膜以及刻蝕工藝,鍍膜後要進行膜厚的測量,刻蝕後要進行刻蝕的深度等進行測量,從而判斷是否滿足工藝要求。台階儀因其使用方便、快捷、準確等特點,而成為工程師們測膜的選擇。
Bruker Dektak XT台階儀在使用過程中操作簡單,整個測試過程在可通過CCD在軟件界麵中實時觀測。
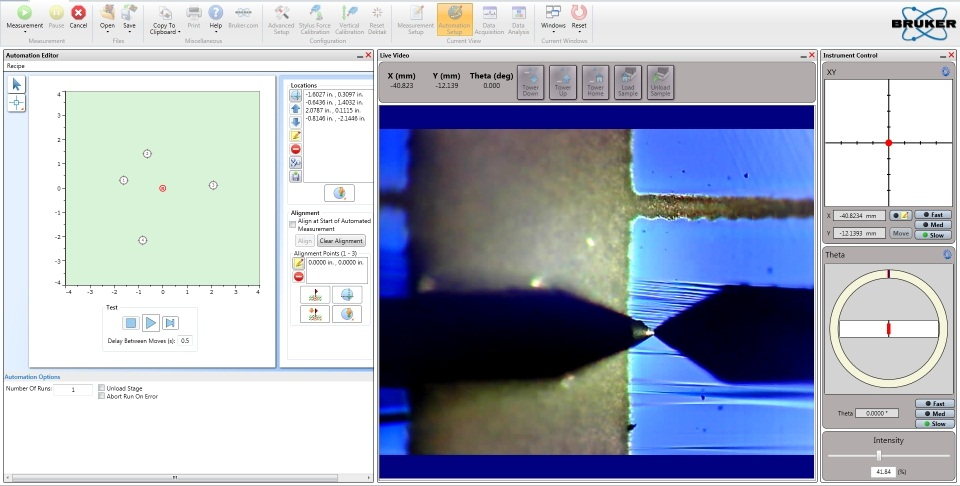
並且很快就能計算出測量結果。

此外台階儀還可以進行表麵線粗糙度、3D表麵形貌測量(自動樣品台)。

粗糙度測量
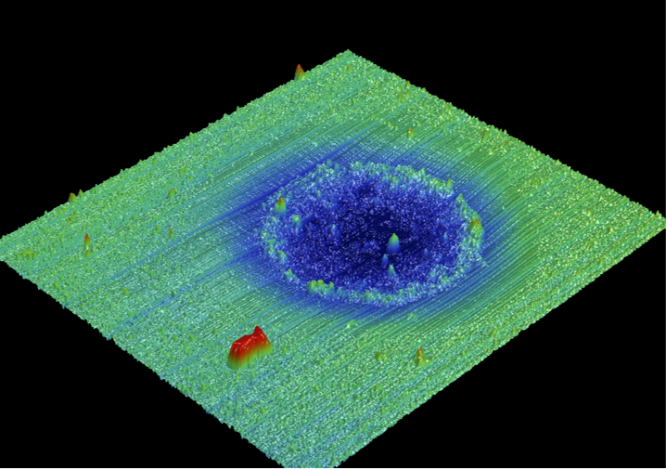
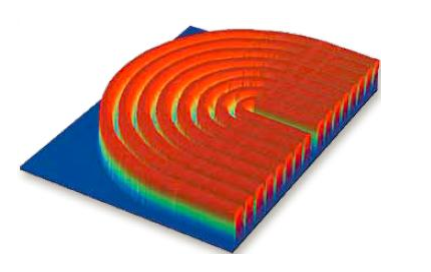
3D形貌測量







